Cutting Process Using Laser
Laser dicing
Process outline of the cutting process using laser
Laser is an abbreviation of Light Amplification by Stimulated Emission of Radiation.
Laser processing is largely divided into 2: Continuous Wave Operation (CW Operation) and Pulsed Operation. For the singulation of semiconductor substrates, Pulsed Operation is mainly used as it can suppress the heat effect.
There are two types of processing methods at DISCO:
- Ablation process
- Stealth Dicing process
Ablation process

The ablation process is a processing method where a high-energy laser beam is focused on the surface of the processing target, thereby melting and subliming the target and removing the physical volume. As it is a process that is not affected by the hardness of the processing target, it can be used to process a variety of materials. Additionally, since processing can be done without coming into contact with the target, high-quality processing without chipping or cracks that usually occur when processing with a machine is possible.
In ablation processing, minute processing particles are generated when processing the target material. If the processing particles adhere to the target's surface, it is not possible to remove them using pure water cleaning alone, and the particles may cause defects such as poor bonding. Due to this, it is normal to spin coat a water-soluble resin on the target's processing surface before ablation processing, thereby preventing the processing particles from adhering on the target's processing surface during ablation, and after ablation, the processing particles along with the water-soluble resin can be washed away using just pure water.

Stealth Dicing


The Stealth Dicing process is a processing method where a laser with a wavelength that is transmissible with regard to the processing target is focused inside the target, and after forming a modified layer (a layer where the crystalline structure is in disarray), singulation is performed using methods such as tape expansion. Since the inside of the processing target is processed, there are no marks on the front and back surfaces, and the generation of processing particles can be suppressed.

As Stealth Dicing is a completely dry process that does not use water, it is suitable for processing targets such as MEMS die, that are vulnerable to load. Since the kerf width can be made narrow for the Stealth Dicing Process, it greatly contributes to street reduction of the processing target.
DISCO is an alliance partner* of Hamamatsu Photonics, which owns the portfolio of patents for Stealth Dicing technology.
*System integrators who are business partners with comprehensive licensing for the portfolio of patents for Hamamatsu Stealth Dicing technology.
https://www.hamamatsu.com/jp/en/product/semiconductor-manufacturing-support-systems/stealth-dicing-technology/alliance-partners.html
Precision processing equipment used
Fully Automatic Laser Saw
-

DFL7161
Processing equipment that support ablation
-
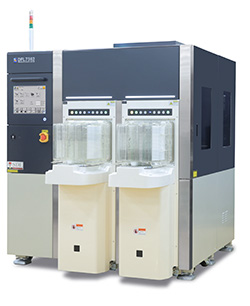
DFL7362
Processing equipment that support Stealth Dicing
-
Equipment models that support Stealth Dicing are equipped with an SD engine, which has a modularized laser and optical system developed by Hamamatsu Photonics for DISCO.
Fully Automatic Laser Saw
The laser saws that are currently being sold come with various automation functions. Mainly, transfer, automatic cut position recognition, and cleaning functions are included, and the target material can be managed per cassette.
Fully Automatic Dicing Saw Using Blades
The fully automatic dicing saws that are currently being sold come with various automation functions. Mainly, transfer, automatic cut position recognition, and cleaning functions are installed, and the target material can be managed per cassette.
Automatic Dicing Saw Using Blades
These processing equipment require an operator to supply the target to be processed. An automatic cut position recognition function is installed.
Applied Processing Tool
Ablation process: Laser head, Water-soluble resin for laser processing
Stealth dicing:Laser head (SD engine)
Main targets of the cutting process using laser
- Semiconductor wafer cutting
- Semiconductor package cutting
- Processing of devices that use all types of electronic or optical components
